客戶積極擴產 印能8月營收2.59億元創單月新高
鉅亨網記者魏志豪 台北
印能科技 (7734-TW) 今 (8) 日公告 8 月營收 2.59 億元,月增 2.74%,年增 75.28%,創單月營收新高,累計前 8 月營收 16.08 億元,年增 38.19%。受惠晶圓大廠積極擴充先進封裝產能,印能相關設備出貨暢旺。
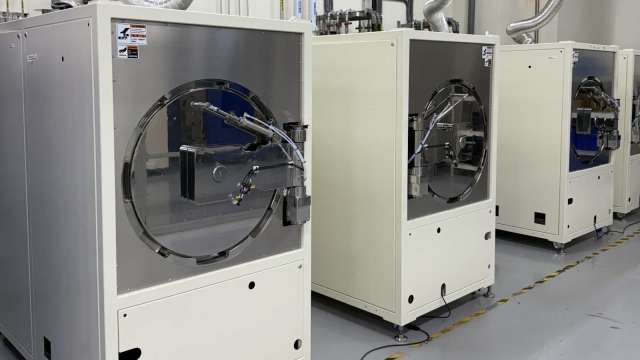
印能今日也宣布,公司研發的「第四代 EvoRTS 真空高壓高溫系統」榮獲有「工程界諾貝爾獎」美譽的 2025 年度 R&D 100 Awards 全球百大科技研發獎。R&D 100 Awards 由美國權威期刊《Research & Development》(R&D Magazine)主辦,自 1963 年創立以來已有超過 60 年歷史。
該獎項素有「工程界諾貝爾獎」與「創新界奧斯卡獎」之譽,每年從全球範圍評選出 100 項最具創新性和影響力的技術發明。在 EvoRTS 同組競賽的發明之中,全球僅有 15 項技術獲獎,印能是唯一來自亞洲的企業,其餘均來自國家實驗室、政府研究機構或一流學府,凸顯印能之技術已達與國際頂尖研發單位比肩的水準。
印能所研發的「第四代 EvoRTS 真空高壓高溫系統」是 RTS 系列新一代機型,其主要功能是將助焊劑殘留去除與空洞消除等流程同時整合於單一爐中,透過最佳化的溫度與壓力實現溶解、擴散與擾動機制,簡化製程並提升效率。
印能無殘留、無空洞的工藝,大幅強化先進 AI 晶片封裝的可靠性,並加速生產週期、降低成本,且可達到節省水、能源與氣體資源的目的。更重要的是,該系統創新地免除了傳統繁複的清洗與後處理步驟,大幅提升製程效率以及封裝良率。
董事長洪誌宏表示,在 Chiplet 先進封裝中,高溫熔焊扮演關鍵角色。由於晶片微縮與堆疊密度提高,凸塊間距已縮小至 20 微米以下,若接合不完全,將導致電性不良與良率下降。高溫熔焊可讓錫膏或銅柱充分熔融並與基板形成穩固金屬間化合物,確保訊號導通與機械強度。
同時,這層金屬接合還能提供高效導熱路徑,避免 AI 與 HPC 晶片在高功耗運作下出現熱聚集或翹曲失效。
然而,傳統封裝迴焊中使用的助焊劑與底部填膠工藝,也為 Chiplet 先進封裝帶來材料殘留難題。迴焊後殘留的助焊劑可能阻礙 Underfill 底填膠流動並侵蝕接合介面,晶片周圍溢出的底填膠甚至會沿晶片側壁爬至背面,影響後續鍵合,這些殘留物不但增加製程複雜度與風險,更會削弱封裝的可靠性。
針對封裝的難題,印能提供先進封裝製程的整合解決方案,研發出完整設備組合來解決氣泡、翹曲、高溫熔錫接合及散熱四大痛點。其中,印能開發的 EvoRTS 系統承襲 VTS 卓越除泡能力的同時,透過優化熱流程與氣流控制,還能針對迴焊助焊劑殘留與底填膠爬膠進行特殊處理。
展望後市,市場對高效能製程解決方案的需求持續升溫。印能憑藉提供先進封裝製程的整合解決方案,已在先進封裝領域展現領導地位,隨著 AI、HPC 與異質整合應用快速成長,印能將受惠於相關訂單持續擴大,為公司營運注入強勁動能。
- 主動選股績效夯!專家配置一鍵打包
- 掌握全球財經資訊點我下載APP
鉅亨贏指標
了解更多#高盈餘高毛利
- 講座
- 公告
上一篇
下一篇